Digitrode
цифровая электроника вычислительная техника встраиваемые системы
Что такое технология GaN для создания силовых компонентов
Что такое нитрид галлий?
Нитрид-галлиевые транзисторы стали высокоэффективной альтернативой кремниевым транзисторам, благодаря способности технологии обеспечить меньшие размеры устройства при заданном сопротивлении включениям и напряжении пробоя, чем у кремния.
Каково основное преимущество GaN над кремниевыми силовыми транзисторами?
GaN имеет более высокую критическую напряженность электрического поля, чем кремний. Его более высокая подвижность электронов позволяет устройству на основе GaN иметь меньший размер для заданного сопротивления открытого канала и пробоя, чем в случае с устройством на основе кремния. Это позволяет физически уменьшить конструкцию устройств, а их электрические выводы максимально сблизить с учетом заданного требования к напряжению пробоя.
Какие два типа силовых полупроводников GaN существуют?
Эти два типа – режим обеднения и режим обогащения. Транзистор режима обеднения (или транзисторы с собственным каналом) обычно включен и отключается за счет подачи отрицательного напряжения относительно истока и стока. Напротив, транзистор режима обогащения (или транзисторы с индуцированным каналом) нормально выключен и включается положительным напряжением, подаваемым на затвор. Транзистор режима обеднения несколько неудобны, потому что при запуске силового преобразователя сначала к силовым компонентам должно быть приложено отрицательное смещение, иначе произойдет короткое замыкание. У транзисторов с режимом обогащения нет такой проблемы: при нулевом смещении на затворе компонент будет выключен и не будет проводить ток.
Имеет ли полевой транзистор GaN внутренний диод?
Транзисторная структура GaN представляет собой чисто латеральное устройство, без паразитного биполярного перехода, имеющегося в кремниевых MOSFET. Следовательно, обратное смещение GaN или «внутренний диод» имеет другой механизм, но аналогичную функцию. При нулевом смещении между затвором и истоком наблюдается отсутствие электронов в области затвора. По мере уменьшения напряжения стока создается положительное смещение на затворе относительно области дрейфа, инжектируя электроны в затвор. Таким образом, в проводимости не участвуют неосновные носители, и, следовательно, нет потерь обратного восстановления. Схемотично GaN транзисторы изображают практически также, как и обычные полевые транзисторы.
Каковы основные требования для включения транзистора GaN?
Это три параметра: максимально допустимое напряжение затвора, порог напряжения затвора и падение напряжения на «внутреннем диоде».
Что наиболее важно при использовании устройств GaN?
Очень важна разводка печатной платы, причем независимо от того, какого типа устройство (с режимом обеднения или режимом обогащения). Все эти устройства переключаются очень быстро, и поэтому паразитная индуктивность платы должна быть как можно меньше, в диапазоне от 0.4 нГн до 2.0 нГ.
Технология GaN – революционный шаг в будущее
Новая технология CoolGaN™ компании Infineon позволяет создавать самые устойчивые на сегодняшний день GaN-транзисторы с высокой производительностью. Комбинируя эти устройства с изолированными драйверами затвора EiceDRIVER™, в состав которых входят трансформаторы без сердечников, разработчики силовой электроники получают возможность создавать преобразователи с более высокой производительностью, чем при использовании стандартных кремниевых транзисторов.
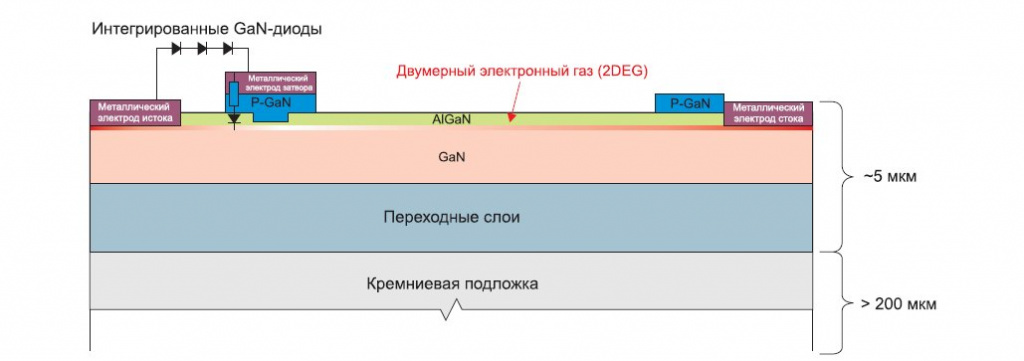
Рис.1. Поперечное сечение 600-В силового транзистора CoolGaN™
В структуре затвора применяются диоды. В результате использования в затворе титана и материала p-GaN образуется омический контакт, расположенный между затвором и истоком последовательно GaN-диоду. Напряжение в точке перегиба вольтамперной характеристики этого диода в прямом направлении равно примерно 3,5 В. Кроме того, в GaN-транзистор интегрированы три последовательных GaN-диода для защиты затвора от электростатического разряда (ESD). Эти диоды начинают ограничивать напряжение затвор–исток, если оно становится меньше –10 В. Напряжение затвора CoolGaN™ регулируется в прямом и обратном направлениях, что обеспечивает высокую стойкость транзистора и защиту от превышения напряжения.
Приложения, в которых GaN обеспечивает максимальную эффективность
Первое, что может прийти в голову разработчику силовой электроники, – заменить имеющиеся транзисторы CoolMOS™ новым GaN-устройством, чтобы определить, насколько эффективнее оно работает. Однако часто эта замена разочаровывает, поскольку лишь в небольшой мере уменьшаются коммутационные потери. Это обусловлено тем, что схемы, в которых обычно применяются транзисторы CoolMOS™, представляют собой однополярные топологии вроде традиционной схемы повышающего корректора коэффициента мощности (ККМ), несимметричного обратноходового или двухтранзисторного прямоходового преобразователя. В этих топологиях, как правило, транзистор проводит только в прямом направлении. Следовательно, об эффективности внутреннего диода речь не идет, поскольку транзистор никогда не проводит в третьем квадранте. Единственными параметрами, которые следует учитывать помимо RDS(on), являются потери энергии при включении EOSS и скорость коммутации. Таким образом, небольшое преимущество GaN-транзистора в этом отношении не играет существенной роли – технология CoolMOS™ уже хорошо опробована и занимает свое почетное место в этих приложениях.
В каких же тогда системах GaN-транзисторы имеют наибольшие преимущества? Считается, что, главным образом, в ВЧ-системах. Однако очень высокая эффективность обеспечивается в полумостовых топологиях даже при небольшой рабочей частоте величиной 65 кГц. На рисунке 2 показана полномостовая топология ККМ с выходным двухтранзисторным каскадом, которая используется в исходном проекте Infineon с GaN ККМ мощностью 2,5 кВт.
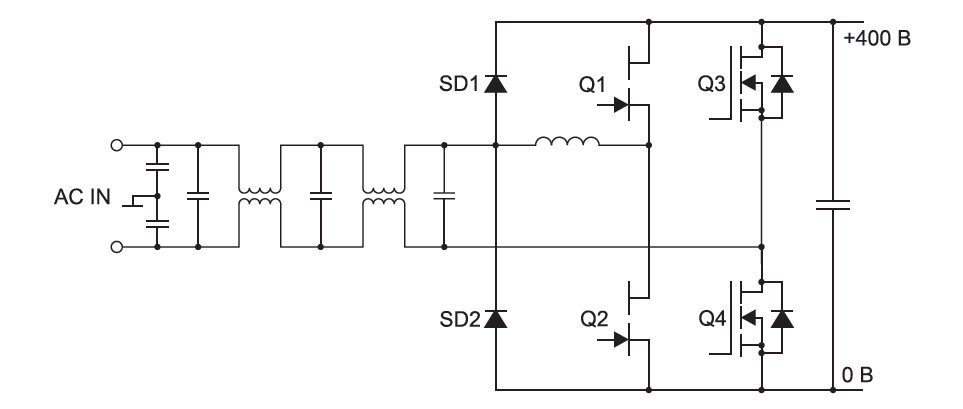
Рис. 2. Полномостовая топология ККМ с выходным двухтранзисторным каскадом
В режиме непрерывной проводимости (CCM) транзисторы Q1 и Q2 работают попеременно как повышающий ключ и синхронный выпрямитель в условиях жесткой коммутации. Если бы стандартные кремниевые высоковольтные силовые транзисторы использовались вместо Q1 и Q2, из-за характеристики обратного восстановления их паразитных внутренних диодов возникали бы существенные коммутационные потери, приводящие к повреждению устройств. Однако у GaN-транзисторов – нулевое обратное восстановление, поскольку отсутствуют неосновные носители заряда, участвующие в канальной проводимости. Таким образом, коммутационные потери достаточно низки особенно потому, что выходная емкость и соответствующая энергия меньше, чем обеспечивают все конкурирующие транзисторные технологии.
Потери настолько малы, что КПД схемы ККМ, показанной на рисунке 6, превышает 99% в наибольшей части диапазона выходной мощности, что видно из рисунка 3. Действительно, пиковый КПД величиной 99,3% – необычно высокий показатель. При выходной мощности 1 кВт потери составляют всего 7 Вт. Схема ККМ исходного проекта от Infineon отражает практическую ситуацию, отвечая всем стандартным требованиям к ККМ, в т.ч. требованиям EN5022 к испытаниям на стойкость к кондуктивным ЭМП, молниевым разрядам и отсутствию линейного режима.

Рис. 3. Результаты измерения эффективности демо-платы с ККМ с выходным двухтранзисторным GaN-каскадом мощностью 2500 Вт
К настоящему времени к числу новых GaN-транзисторов компании Infineon относятся устройства IGx70R060D1 (600-В 70-мОм), которые выпускаются в четырех разных корпусах для поверхностного монтажа, включая охлаждаемые с верхней и тыльной сторон DSO, TOLL и DFN размером 8×8 мм. 190-мОм GaN-транзисторы изготавливаются в корпусах TOLL. Ожидается, что в ближайшее время эта продуктовая линейка пополнится транзисторами с сопротивлением 35 и 340 мОм, которые будут выпускаться в тех же четырех корпусах.
Мощные нитрид-галлиевые транзисторы (GaN) от EPC – конец эры кремния?
До недавнего времени преимущества силовых транзисторов на нитриде галлия перед кремниевыми было невозможно реализовать на практике из-за того, что в обычных условиях они являются нормально-открытыми. Благодаря разработанной компанией EPC технологии производства нитрид-галлиевой ячейки стало возможным наладить выпуск нормально-закрытых изделий. Перспективные приложения для eGaN®FET – DC/DC-преобразователи для различных приложений, усилители мощности класса D, инверторы, системы беспроводной передачи мощности, лидары, системы подстройки питания ВЧ-усилителей (Envelope Tracking), системы с повышенной температурной и радиационной стойкостью.
Рынок силовых компонентов является чрезвычайно насыщенным и отличается жесточайшей конкуренцией. Новая компания может выйти на него только при наличии революционных идей. И такая прорывная идея есть у Efficient Power Conversion (EPC). За семь лет работы компания EPC смогла решить сложнейшие технологические проблемы и наладить серийный выпуск GaN-транзисторов с улучшенной структурой – eGaN® FET, которые уже теснят стандартные силовые кремниевые MOSFET в целом ряде приложений.
Рынок силовых полупроводников является растущим сегментом электроники [1]. По оценкам экспертов, в 2012 году его объем превысил 12 миллиардов долларов (рисунок 1).
Рис. 1. Структура рынка силовых полупроводниковых элементов
Ярким примером такой компании является Efficient Power Conversion (EPC) [2]. Компания была основана одним из создателей первого MOSFET-транзистора Алексом Лидовым, который долгое время работал в International Rectifier (IR). В 2007 году он ушел с поста исполнительного директора IR и совместно с тайваньским бизнесменом Арчи Хваном (Archie Hwang) организовал EPC. При этом для ведения научных исследований были наняты специалисты, занимавшиеся разработками GaN-транзисторов в International Rectifier. Компания за несколько лет сумела решить все технические проблемы и создать уникальную структуру транзисторов eGaN® FET. Это позволило EPC стать лидером данного сегмента рынка.
Сейчас EPC обладает широкой номенклатурой продуктов, которая включает:
При разговоре о GaN-транзисторах у большинства разработчиков может возникнуть множество вопросов. В чем причина выбора именно GaN? Почему столь бурное развитие началось только сейчас? Каковы характеристики полученных серийных образцов? Где находятся области их применения? Имеет ли данная технология перспективы развития?
В данной статье даются ответы на перечисленные вопросы, проводится обзор номенклатуры eGaN FET-компонентов и средств разработки производства компании EPC.
GaN – новое или хорошо забытое старое?
Победное шествие силовых кремниевых полупроводников длится уже более трех десятилетий – с момента появления в конце 70-х силового MOSFET. Долгое время кремний не имел конкурентов, так как другие известные полупроводники (германий и селен) значительно уступали ему практически по всем важным показателям. Позже полупроводниковые свойства были открыты и у новых материалов – арсенида и нитрида галлия, карбида кремния, и тому подобных.
Впрочем, нужно отметить, что, например, GaN не является таким уж «новым». Впервые его особые свойства были обнаружены еще в 1975 году Т. Мимурой, а их подробное исследование было выполнено в 1994 году М. Канном.
Эти исследования показали, что GaN – гораздо более перспективный материал, чем кремний (таблица 1) [3].
Таблица 1. Характеристики некоторых полупроводниковых материалов
| Параметр | Материал | ||
| GaN | Si | SiС | |
| Ширина запрещенной зоны, эВ | 3,4 | 1,12 | 3,2 |
| Критическая напряженность, МВ/см | 3,3 | 0,3 | 3,5 |
| Дрейфовая скорость насыщения электронов, x107 см/с | 2,5 | 1 | 2 |
| Подвижность, см2/(В•с) | 990…2000 | 1500 | 650 |
| Диэлектрическая проницаемость | 9,5 | 11,4 | 9,7 |
Высокая критическая напряженность поля у GaN дает потенциальную возможность реализовывать более высоковольтные приборы. Большая ширина запрещенной зоны обеспечивает высочайшую стабильность свойств при изменении температуры или воздействии радиации, что чрезвычайно важно в первую очередь для космической и военной электроники, а также для устройств, работающих в жестких условиях.
Высокая подвижность электронов и дрейфовая скорость определяют значительно меньшее сопротивление в проводящем состоянии и высокую удельную мощность, по сравнению с Si.
Весьма показательным является анализ зависимости удельного сопротивления от напряжения пробоя для различных полупроводников (рисунок 2) [4]. Для каждого из них эта характеристика практически линейная. Однако при одном и том же значении напряжения сопротивление GaN оказывается значительно ниже.
Рис. 2. Зависимость удельного сопротивления от напряжения пробоя для различных полупроводников
В результате GaN-транзисторы имеют на порядок большую удельную мощность, что должно приводить к значительному уменьшению габаритов по сравнению с традиционными кремниевыми элементами, и в лабораторных опытах это было убедительно доказано.
К сожалению, между лабораторными опытами и серийным промышленным производством очень часто лежит непреодолимая пропасть. В случае использования GaN наряду с преимуществами было огромное число недостатков и проблем как технологического, так и коммерческого характера.
Базовая структура GaN-транзистора: простота и сложность в одном флаконе
Рассмотрим самую простую традиционную ячейку GaN-транзистора (рисунок 3а) [4]. На кремниевой подложке выращивается защитный слой AlN. На нем формируется гетероструктура GaN/AlGaN. Далее создаются защитный диэлектрический слой и электроды.
Рис. 3. Традиционная ячейка а) GaN-транзистора и б) eGaN® FET производства EPC
GaN и AlGaN имеют полярную природу. По этой причине уже в процессе роста на их границе происходит спонтанная поляризация с образованием поверхностных зарядов. Кроме того, GaN обладает выраженными пьезоэлектрическими свойствами. Под действием деформации и механических напряжений он дополнительно поляризуется. Так как решетки GaN и AlGaN имеют рассогласование, то такие напряжения неизбежно возникают на границе их раздела [3].
В результате процессы поляризации вызывают формирование заряда в виде двухмерной плоскости (двухмерный электронный газ, 2DEG) [3].
Если на электроды стока и истока такой базовой ячейки подать напряжение, то начнет протекать ток, даже если напряжение на затворе равно нулю. Таким образом данный прибор является нормально открытым.
Чтобы прекратить протекание тока на затвор, необходимо подать отрицательное напряжение относительно истока (рисунок 3а).
Вполне очевидно, что такой транзистор весьма неудобен в использовании. Во-первых, чтобы избежать выгорания схемы, необходимо до включения основного питания обеспечить выключение транзистора. А во-вторых — необходимо иметь дополнительный источник отрицательного напряжения.
На этом проблемы с «простой» ячейкой не заканчиваются. Дело в том, что представленная структура имеет чрезвычайно упрощенный вид. На самом деле она гораздо сложнее.
Для эффективного отвода тепла от слоя GaN необходимо наличие подложки, а все стандартные материалы (Si, SiC, сапфир) имеют рассогласование кристаллических решеток с GaN. Чтобы снизить механические напряженности, вводят дополнительные согласующие слои. Аналогично добавляются и слои между другими разнородными материалами ячейки. В результате структура оказывается сложной [3].
Дополнительные проблемы вносит тот факт, что готовых решений не существует и необходимо проводить затратные исследования для выявления оптимальных материалов, толщины слоев и так далее.
Здесь в дело вступает коммерческий или, в каком-то смысле, «политический» аспект. Дело в том, что никто не спешит выделять средства на новые разработки в то время как есть готовые отточенные и выверенные до нанометров кремниевые технологии. Гиганты отрасли не горят большим желанием вкладываться в такие проекты, тем более гарантий их коммерческого успеха нет. И здесь в дело вступили молодые и амбициозные компании, одной из которых является EPC.
Остановимся подробнее на основных технологических решениях, предложенных EPC, и проведем краткий анализ полученных результатов.
Структура eGaN® FET от EPC – все гениальное просто
Инженеры EPC проявили высочайшую трудоспособность, результатом которой стало фантастически быстрое решение всех озвученных выше проблем.
Во-первых, была предложенная улучшенная структура ячейки транзистора, которая получила название eGaN® FET (Enhancement Mode) (рисунок 3б). Фундаментальные изменения коснулись формирования затвора и подзатворной области [4].
В этой ячейке под затвором формируется обедненная область AlGaN, поэтому поляризации GaN не происходит и формируется разрыв области электронного газа 2DEG.
Транзистор оказывается нормально закрытым прибором. Чтобы сформировать проводящий канал между стоком и истоком, необходимо приложить к затвору положительное напряжение относительно истока. В итоге работа eGaN абсолютно идентична работе обычного N-MOSFET!
Стоит сказать, что представленная структура является максимально упрощенной. Реальная ячейка имеет гораздо более сложный вид. Однако все технологические проблемы были решены, что сделало возможным серийный выпуск eGaN FET.
Появление серийных образцов дает абсолютную свободу для сравнения характеристик новых транзисторов и их кремниевых предшественников. Постараемся в таблице 2 дать объективный анализ с указанием достоинств и недостатков представителей каждой из технологий [5].
Таблица 2. Качественное сравнение силовых ключей 100 В
| Параметр | Типовой кремниевый MOSFET 100 В | eGaN EPC2022 100 В |
| Rси откр., мОм | единицы-десятки | 2,4 |
| Изменение сопротивления Rси откр. при изменении температуры 125°C/25°C | 2,2 | 1,4 |
| Энергия на переключения | высокая | низкая |
| Время восстановления обратного диода | большое | отсутствует |
| Пороговое напряжение Uзи пор., В | 2…4 | 0,7…2,5 |
| Изменение Uзи пор. при изменении температуры 125°C/25°C | 0,66 | 1 |
| Максимальное напряжение Uзи, В | ±20 | -1,5 |
| Рабочая температура, °C | 150 | 150 |
| Входное сопротивление затвора Rg, Ом | несколько | 0,3 |
| Входной ток Iзи | несколько нА | 1 мА |
Сопротивление открытого канала канала Rси откр, мОм – одна из важнейших характеристик, определяющих потери на ключе. Типовое значение сопротивления близко для серийных образцов обоих транзисторов, но здесь следует сделать несколько замечаний.
Во-первых, как было сказано выше, GaN имеет более стабильные характеристики. Для него значение Rси в диапазоне температур 25…125°C меняется примерно в 1,4 раза. Сопротивление же MOSFET меняется более чем в 2,2 раза.
Во-вторых, зависимость сопротивления от максимального рабочего напряжения для GaN значительно слабее, чем у MOSFET. Это связано с тем, что увеличение длины канала «Сток-Исток» не так критически сказывается на величине сопротивления. Например, сопротивление 30 В транзистора EPC2023 составляет 1,3 мОм, а 200 В транзистора EPC2034 – всего 10 мОм.
Емкость С, пФ, определяет быстродействие транзистора. Предложенная плоская структура eGaN FET имеет минимальные значения емкостей CGD и CDS. Это позволяет коммутировать напряжения в сотни вольт с гигагерцевой частотой и снижать габариты преобразователей напряжения.
Пороговое напряжение Uзи пор., В, составляет для GaN всего 0,7…2,5 В, с первого взгляда это является достоинством из-за сокращения потерь мощности на управлении, но это, к сожалению, не так из-за больших входных токов. Кроме того, низкое Uзи пор. уменьшает стойкость транзистора к изменениям dv/dt.
Важно отметить, что максимальное значение напряжения на затворе GaN-транзистора составляет, как правило, всего +6 В/-4 В.
Входное сопротивление затвора Rg, Ом, определяет скорость перезаряда входной емкости. Для GaN данное сопротивление достаточно мало, что приводит к высокому быстродействию и улучшению защиты dv/dt. В то же время значения входных токов увеличиваются, а значит – растет и мощность управления.
Обратный диод. Предложенная схема GaN-транзистора не имеет обратного диода как такового. Однако есть механизм обратной проводимости, который выполняет его функцию. При этом интересен тот факт, что при обратном направлении тока не происходит накопления неосновных носителей, в отличие от MOSFET. А это значит, что потери на восстановление обратного диода отсутствуют.
Таким образом eGaN FET-транзистор имеет отличные электрические характеристики, но все еще уступает MOSFET в плане удобства управления. Поэтому на настоящий момент данный тип силовых ключей будет иметь преимущество перед MOSFET не всегда. Тем не менее, уже сейчас можно выделить перспективные приложения для eGaN FET: DC/DC-преобразователи для различных приложений, усилители мощности класса D, инверторы, системы беспроводной передачи мощности, лидары, системы подстройки питания ВЧ-усилителей (Envelope Tracking), системы с повышенной температурной и радиационной стойкостью.
В качестве демонстрации преимуществ использования eGaN FET можно привести результаты опытных испытаний [6]. Были построены и исследованы DC/DC-преобразователи 12 В/1,2 В с рабочей частотой 1 МГц и 48 В/12 В с рабочей частотой 300 кГц (рисунок 4). Из графиков видно, что при увеличении рабочих частот и выходных токов преимущество eGaN FET перед MOSFET возрастает. Наилучшие результаты продемонстрировали GaN-транзисторы четвертого поколения: для первого преобразователя максимальный КПД составил более 91%, а для второго – более 98%. Это значительно выше показателей альтернативного DC/DC на MOSFET-ключах.
Рис. 4. Результаты сравнительных испытаний DC/DC-преобразователей
Стоит отметить, что EPC постоянно совершенствует технологии и конструкцию своих элементов. За семь лет было создано четыре поколения силовых компонентов. Сейчас выпускаются представители двух поколений: Gen2 и Gen4, которые имеют обратную совместимость с более ранними разработками.
Обзор номенклатуры eGaN FET от EPC
Линейку силовых компонентов производства компании EPC составляют три основные группы:
Все эти элементы выпускаются в LGA-корпусах (рисунок 5).
Рис. 5. Примеры корпусных исполнений дискретных eGaN® FET
Группа дискретных eGaN FET объединяет в себя представителей двух поколений транзисторов с рабочими напряжениями 30…450 В (таблица 3).
Таблица 3. Дискретные eGaN® FET общего назначения
| Наименование | Uси макс., В | Uзи макс., В | Rси (вкл) макс., мОм, при Uзи = 5 В | Qз тип., нК | Qзи тип., нК | Qзс тип., нК | Iс, А | Iс имп., А | Tj макс., °C | LGA-корпус, мм |
| EPC2023 | 30 | 6 | 1,3 | 20 | 5,8 | 1,9 | 60 | 590 | 150 | 6,1х2,3 |
| EPC2024 | 40 | 6 | 1,5 | 19 | 6,4 | 2 | 60 | 550 | 150 | 6,1х2,3 |
| EPC2030 | 40 | 6 | 2,4 | 18 | 5,2 | 3,4 | 31 | 495 | 150 | 4,6х2,6 |
| EPC2015C | 40 | 6 | 4 | 8,7 | 3 | 1,4 | 36 | 235 | 150 | 4,1х1,6 |
| EPC2015 | 40 | 6 | 4 | 10,5 | 3 | 2,2 | 33 | 150 | 150 | 4,1х1,6 |
| EPC2014C | 40 | 6 | 16 | 2 | 0,7 | 0,3 | 10 | 60 | 150 | 1,7х1,1 |
| EPC2014 | 40 | 6 | 16 | 2,5 | 0,67 | 0,48 | 10 | 40 | 150 | 1,7х1,1 |
| EPC2020 | 60 | 6 | 2 | 16 | 5 | 2 | 60 | 470 | 150 | 6,1х2,3 |
| EPC2031 | 60 | 6 | 2,6 | 17 | 5,2 | 3,2 | 31 | 450 | 150 | 4,6х2,6 |
| EPC2035 | 60 | 6 | 45 | 0,88 | 0,25 | 0,16 | 1 | 24 | 150 | 0,9х0,9 |
| EPC2021 | 80 | 6 | 2,5 | 15 | 3,8 | 2,1 | 60 | 420 | 150 | 6,1х2,3 |
| EPC2029 | 80 | 6 | 3,2 | 13 | 4 | 2,5 | 31 | 360 | 150 | 4,6х2,6 |
| EPC2022 | 100 | 6 | 3,2 | 13 | 3,7 | 2 | 60 | 360 | 150 | 6,1х2,3 |
| EPC2032 | 100 | 6 | 4 | 14 | 4,2 | 3,1 | 31 | 340 | 150 | 4,6х2,6 |
| EPC2001C | 100 | 6 | 7 | 7,5 | 2,4 | 1,2 | 36 | 150 | 150 | 4,1х1,6 |
| EPC2001 | 100 | 6 | 7 | 8 | 2,3 | 2,2 | 25 | 100 | 125 | 4,1х1,6 |
| EPC2016C | 100 | 6 | 16 | 3,4 | 1,1 | 0,55 | 18 | 75 | 150 | 2,1х1,6 |
| EPC2016 | 100 | 6 | 16 | 3,8 | 0,99 | 0,7 | 11 | 50 | 125 | 2,1х1,6 |
| EPC2007C | 100 | 6 | 30 | 1,6 | 0,6 | 0,3 | 6 | 40 | 150 | 1,7х1,1 |
| EPC2007 | 100 | 6 | 30 | 2,1 | 0,52 | 0,61 | 6 | 25 | 125 | 1,7х1,1 |
| EPC2036 | 100 | 6 | 65 | 0,7 | 0,17 | 0,14 | 1 | 18 | 150 | 0,9х0,9 |
| EPC2033 | 150 | 6 | 7 | 10 | 3,5 | 1,7 | 31 | 260 | 150 | 4,6х2,6 |
| EPC2018 | 150 | 6 | 25 | 5 | 1,3 | 1,7 | 12 | 60 | 125 | 3,6х1,6 |
| EPC2034 | 200 | 6 | 10 | 8,5 | 2,6 | 1,4 | 31 | 140 | 150 | 4,6х2,6 |
| EPC2010C | 200 | 6 | 25 | 3,7 | 1,3 | 0,7 | 22 | 90 | 150 | 3,6х1,6 |
| EPC2010 | 200 | 6 | 25 | 5 | 1,3 | 1,7 | 12 | 60 | 125 | 3,6х1,6 |
| EPC2019 | 200 | 6 | 50 | 1,8 | 0,6 | 0,35 | 8,5 | 42 | 150 | 2,7х0,95 |
| EPC2012C | 200 | 6 | 100 | 1 | 0,3 | 0,2 | 5 | 22 | 150 | 1,7х0,9 |
| EPC2012 | 200 | 6 | 100 | 1,5 | 0,33 | 0,57 | 3 | 15 | 125 | 1,7х0,9 |
| EPC2025 | 300 | 6 | 150 | 1,85 | 0,61 | 0,3 | 4 | 20 | 150 | 1,95х1,95 |
| EPC2027 | 450 | 6 | 400 | 1,7 | 0,6 | 0,25 | 4 | 12 | 150 | 1,95х1,95 |
Все представленные силовые ключи имеют малое сопротивление. Рекордное Rси составляет 1,3 мОм для EPC2023 – ключа 30 В. При этом зависимость сопротивления от рабочего напряжения внутри данного сегмента оказывается не такой сильной, как в MOSFET.
Максимальные среднеквадратичные токи данной группы элементов в большинстве случаев составляют десятки ампер, а импульсные токи – десятки и сотни. Несмотря на столь внушительную мощность, все транзисторы выполнены в миниатюрных корпусах, наиболее крупным из которых является LGA 6,1×2,3 мм, а наиболее компактным – LGA 0,9×0,9 мм (рисунок 5).
Группа eGaN FET EPC800x предназначена для работы в субгигагерцевом диапазоне. Именно в ВЧ-приложениях GaN-транзисторы с самого начала завоевали господствующее положение.
Они – отличный выбор при построении приложений с жесткими режимами переключения силовых ключей и рабочими частотами от десятков до сотен МГц.
В настоящее время доступны EPC800x с рабочими напряжениями 40…100 В (таблица 4). Корпусное исполнение для всех представителей группы одинаково – LGA 2,1×0,85 мм (рисунок 5).
Таблица 4. eGaN® FET для ВЧ-приложений
| Наименование | Uси макс., В | Uзи макс., В | Rси вкл. макс., мОм, при Uзи = 5 В | Qз тип., нК | Qзи тип., нК | Qзс тип., нК | Iс, А | Iс имп., А | Tj макс., °C | LGA-корпус, мм |
| EPC8004 | 40 | 6 | 110 | 0,37 | 0,12 | 0,047 | 2,7 | 7,5 | 150 | 2,1х0,85 |
| EPC8007 | 40 | 6 | 160 | 0,302 | 0,097 | 0,025 | 2,7 | 6 | 150 | 2,1х0,85 |
| EPC8008 | 40 | 6 | 325 | 0,177 | 0,067 | 0,012 | 2,7 | 2,9 | 150 | 2,1х0,85 |
| EPC8009 | 65 | 6 | 130 | 0,37 | 0,12 | 0,055 | 2,7 | 7,5 | 150 | 2,1х0,85 |
| EPC8005 | 65 | 6 | 275 | 0,218 | 0,077 | 0,018 | 2,7 | 3,8 | 150 | 2,1х0,85 |
| EPC8002 | 65 | 6 | 530 | 0,141 | 0,059 | 0,0094 | 2* | 2 | 150 | 2,1х0,85 |
| EPC8010 | 100 | 6 | 160 | 0,36 | 0,13 | 0,06 | 2,7 | 7,5 | 150 | 2,1х0,85 |
| EPC8003 | 100 | 6 | 300 | 0,315 | 0,11 | 0,034 | 2,7 | 5 | 125 | 2,1х0,85 |
Основными приложениями для EPC800x стали системы подстройки питания ВЧ-усилителей (Envelope Tracking) и системы беспроводной передачи мощности.
Рис. 6. Внутренняя схема eGaN® FET-сборок
Группа интегральных сборок eGaN FET содержит шесть компонентов с рабочими напряжениями 30…100 В (таблица 5). Все сборки представляют собой полумостовые схемы (рисунок 6).
Интегральные сборки eGaN FET могут иметь симметричную и несимметричную структуру (рисунок 7) [7].
В симметричной конфигурации размеры кристаллов транзисторов обоих плеч равны. Соответственно, сопротивление верхнего и нижнего ключей одинаковы. Такая схема подходит для усилителей класса D, приводов электродвигателей, в которых оба транзистора имеют равный нагрузочный диапазон.
В асимметричной конфигурации размер кристалла верхнего транзистора примерно в четыре раза меньше, чем нижнего. Их сопротивления также оказываются разными. Такая асимметрия выгодна, например, для DC/DC-преобразователей, работающих при малых длительностях импульсов, при больших разностях между входным и выходным напряжением. В таких случаях нижний ключ оказывается нагруженным значительно больше.
Таблица 5. Интегральные сборки eGaN® FET общего назначения
| Наименование | Тип | Uси макс., В | Uзи макс., В | Rси вкл. макс., мОм, при Uзи = 5 В | Qз тип., нК | Qзи тип., нК | Qзс тип., нК | Iс, А | Iс имп., А | TJ макс., °C | LGA-корпус, мм |
| EPC2100 | Асимметричный | 30 | 6 | 8; 2 | 3,5; 15 | 1,4; 4,6 | 0,57; 2,6 | 9,5; 38 | 100; 400 | 150 | 6,1х2,3 |
| EPC2101 | Асимметричный | 60 | 6 | 11,5; 2,7 | 2,7; 12 | 1; 3,7 | 0,50; 2,5 | 9,5; 38 | 80; 350 | 150 | 6,1х2,3 |
| EPC2102 | Симметричный | 60 | 6 | 4,4 | 6,8 | 2,3 | 1,4 | 23 | 215 | 150 | 6,1х2,3 |
| EPC2105 | Асимметричный | 80 | 6 | 14,5; 3,5 | 2,5; 10 | 1; 3,2 | 0,50; 2 | 9,5; 38 | 75; 320 | 150 | 6,1х2,3 |
| EPC2103 | Симметричный | 80 | 6 | 5,5 | 6,5 | 2 | 1,3 | 23 | 195 | 150 | 6,1х2,3 |
| EPC2104 | Симметричный | 100 | 6 | 6,3 | 7 | 2 | 1,2 | 23 | 165 | 150 | 6,1х2,3 |
Рис. 7. Доступные конфигурации eGaN® FET-сборок производства EPC
Использование интегральных сборок вместо дискретных компонентов может быть выгодно по ряду причин. Во-первых, удается создать более компактные решения. Во-вторых, сборка имеет минимальные значения паразитных индуктивностей, что дает дополнительные преимущества на более высоких частотах (рисунок 8) [7].
Рис. 8. Преимущество eGaN® FET-сборок на высоких частотах
Для управления eGaN FET, имеющего ряд особенностей, необходимо использовать специальные драйверы.
Драйверы eGaN FET
Драйверы eGaN FET должны не только формировать соответствующие управляющие токи и напряжения, но и иметь дополнительные особенности. Это относится и к используемым контроллерам.
Во-первых, они должны иметь повышенные рабочие частоты. Во-вторых, отличаться минимальными собственными потерями. В-третьих, включение и выключение транзисторов должно осуществляться с безопасными уровнями dv/dt и di/dt.
Чтобы избежать проблем, компания EPC составила список рекомендуемых микросхем управления (таблица 6). Сейчас наиболее оптимальным является использование драйверов LM5113 и LM5114 производства компании Texas Instruments.
Таблица 6. Рекомендуемые драйверы и контроллер eGaN® FET
| Наименование | Функционал | Производитель | Описание |
| LM5113 | Драйвер | Texas Instruments | 5 А, 100 В полумостовой драйвер eGaN FETs |
| LM5114 | Драйвер | Texas Instruments | 7,6 A одноканальный драйвер нижнего ключа |
| UCC27611 | Драйвер | Texas Instruments | 4 А/ 6 А высокоскоростной 5 В одноканальный драйвер |
| ADP1851 | Контроллер | Analog Devices | Понижающий контроллер 2,75 В/20 В |
| ISL6420 | Контроллер | Intersil | Синхронный понижающий контроллер 4,5 В/16 В |
| LM27403 | Контроллер | Texas Instruments | Синхронный понижающий контроллер 3 В/20 В |
| LTC3833 | Контроллер | Linear Technologies | Понижающий контроллер 4,5 В/38 В |
| LTC3891 | Контроллер | Linear Technologies | Синхронный понижающий контроллер с низким потреблением 60 В |
| MAX15026B | Контроллер | Maxim | Синхронный понижающий контроллер 4,5 В/28 В |
| MCP19118/19 | Контроллер | Microchip | Понижающий ШИМ-контроллер 4,5 В/40 В |
| SC419 | Контроллер | Semtech | Понижающий контроллер с интегрированным диодом 3 В/28 В |
| TP253219A | Контроллер | Texas Instruments | Синхронный понижающий контроллер 4,5 В/25 В |
| TPS40490 | Контроллер | Texas Instruments | Понижающий ШИМ-контроллер 4,5 В/60 В |
| UCC24610 | Контроллер | Texas Instruments | Синхронный понижающий контроллер для вторичной обмотки |
Важно понимать, что создание мощных преобразователей и ВЧ-приборов требует большого мастерства и повышенного внимания [8]. Для минимизации ошибок на первых этапах при разработке логично использовать готовые решения.
Средства отладки и разработки от EPC
Рис. 9. Внешний вид готовых модулей DrGaNPLUS
Компания EPC предоставляет разработчикам всю необходимую информационную поддержку: документацию на компоненты, модели (PSPICE, TSPICE, LTSPICE), библиотеки посадочных мест для Altium Designer, тепловые модели. Однако большое количество тонкостей может привести к возникновению недочетов или даже ошибок при проектировании. Чтобы избежать этого, а также быстро освоить новые приборы, следует воспользоваться готовыми решениями:
Отладочные платы eGaN FET (таблицы 7, 8) представляют собой готовые печатные платы с полумостовой схемой, драйвером, необходимыми дополнительными пассивными компонентами и логикой. Практически для каждого eGaN FET имеется своя отладочная плата. Это касается как дискретных транзисторов и интегральных сборок (таблица 7), так и eGaN FET для ВЧ-приложений (таблица 8).
Таблица 7. Отладочные платы eGaN® FET общего назначения
| Наименование | Описание | Uси макс., В | Iс макс., А | Тип транзистора |
| EPC9036 | Отладочная схема на базе интегрального полумоста | 30 | 25 | EPC2100 |
| EPC9031 | Полумостовая схема с драйвером | 30 | 40 | EPC2023 |
| EPC9018 | Полумостовая схема с драйвером для приложений с минимальным коэффициентом заполнения | 30 | 35 | EPC2015/EPC2023 |
| EPC9016 | Полумостовая схема с драйвером для приложений с минимальным коэффициентом заполнения | 40 | 25 | EPC2015 |
| EPC9032 | Полумостовая схема с драйвером | 40 | 35 | EPC2024 |
| EPC9005C | Полумостовая схема с драйвером | 40 | 7 | EPC2014C |
| EPC9005 | Полумостовая схема с драйвером | 40 | 7 | EPC2014 |
| EPC9001 | Полумостовая схема с драйвером | 40 | 15 | EPC2015 |
| EPC9037 | Отладочная схема на базе интегрального полумоста | 60 | 22 | EPC2101 |
| EPC9038 | Отладочная схема на базе интегрального полумоста | 60 | 20 | EPC2102 |
| EPC9033 | Полумостовая схема с драйвером | 60 | 30 | EPC2020 |
| EPC9049 | Полумостовая схема с драйвером | 60 | 4 | EPC2035 |
| EPC9046 | Полумостовая схема с драйвером | 80 | 22 | EPC2029 |
| EPC9034 | Полумостовая схема с драйвером | 80 | 27 | EPC2021 |
| EPC9041 | Отладочная схема на базе интегрального полумоста | 80 | 20 | EPC2105 |
| EPC9039 | Отладочная схема на базе интегрального полумоста | 80 | 17 | EPC2103 |
| EPC9019 | Полумостовая схема с драйвером для приложений с минимальным коэффициентом заполнения | 80 | 20 | EPC2001/EPC2021 |
| EPC9040 | Отладочная схема на базе интегрального полумоста | 100 | 15 | EPC2104 |
| EPC9035 | Полумостовая схема с драйвером | 100 | 25 | EPC2022 |
| EPC9006 | Полумостовая схема с драйвером | 100 | 5 | EPC2007 |
| EPC9010C | Полумостовая схема с драйвером | 100 | 7 | EPC2016C |
| EPC9010 | Полумостовая схема с драйвером | 100 | 7 | EPC2016 |
| EPC9050 | Полумостовая схема с драйвером | 100 | 2,5 | EPC2036 |
| EPC9002 | Полумостовая схема с драйвером | 100 | 10 | EPC2001 |
| EPC9047 | Полумостовая схема с драйвером | 150 | 12 | EPC2033 |
| EPC9014 | Полумостовая схема с драйвером | 200 | 4 | EPC2019 |
| EPC9017 | Полумостовая схема с драйвером для приложений с минимальным коэффициентом заполнения | 100 | 20 | EPC2001 |
| EPC9013 | Отладочная схема четырех параллельных полумостовых схем | 100 | 35 | EPC2001 |
| EPC9004C | Полумостовая схема с драйвером | 200 | 3 | EPC2012C |
| EPC9004 | Полумостовая схема с драйвером | 200 | 3 | EPC2012 |
| EPC9014 | Полумостовая схема с драйвером | 200 | 4 | EPC2019 |
| EPC9003C | Полумостовая схема с драйвером | 200 | 5 | EPC2010C |
| EPC9003 | Полумостовая схема с драйвером | 200 | 5 | EPC2010 |
| EPC9042 | Полумостовая схема с драйвером | 300 | 3 | EPC2025 |
| EPC9044 | Полумостовая схема с драйвером | 400 | 1,5 | EPC2027 |
Таблица 8. Отладочные платы eGaN® FET для ВЧ-приложений
| Наименование | Описание | Uси макс., В | Iс макс., А | Тип транзистора |
| EPC9024 | Полумостовая схема с драйвером | 40 | 4,4 | EPC8004 |
| EPC9027 | Полумостовая схема с драйвером | 40 | 3,5 | EPC8007 |
| EPC9028 | Полумостовая схема с драйвером | 40 | 2,2 | EPC8008 |
| EPC9022 | Полумостовая схема с драйвером | 65 | 1,6 | EPC8002 |
| EPC9025 | Полумостовая схема с драйвером | 65 | 2,2 | EPC8005 |
| EPC9029 | Полумостовая схема с драйвером | 65 | 3,5 | EPC8009 |
| EPC9023 | Полумостовая схема с драйвером | 100 | 2,2 | EPC8003 |
| EPC9030 | Полумостовая схема с драйвером | 100 | 3,2 | EPC8010 |
В качестве наглядного примера компания EPC выпускает целую группу демонстрационных наборов: понижающих преобразователей, наборов беспроводной передачи мощности, усилителей класса D (таблица 9).
Таблица 9. Демонстрационные наборы eGaN® FET
| Наименование | Описание | Uвх, В | Uвых, В | Iс макс, А | Тип транзистора |
| EPC9101 | Понижающий преобразователь 19 В/1,2 В, 1 МГц | 8…19 | 1,2 | 18 | EPC2015/EPC2014 |
| EPC9102 | Понижающий преобразователь 48 В/12 В | 36…60 | 12 | 17 | EPC2001 |
| EPC9105 | Понижающий преобразователь 48 В/2 В, 1,2 МГц | 36…60 | 12 | 30 | EPC2001/EPC2015 |
| EPC9106 | 150 Вт/8 Ом аудиоусилитель класса D | – | – | – | EPC2016 |
| EPC9107 | Понижающий преобразователь 28 В/3,3 В | 9…28 | 3,3 | 15 | EPC2015 |
| EPC9111 | Демонстрационный набор беспроводный передачи энергии, соответствующий требованиям A4WP | 8…32 | Uвх | 10 | EPC2014 |
| EPC9112 | Демонстрационный набор беспроводный передачи энергии соответствующий требованиям A4WP | 8…32 | Uвх | 6 | EPC2007 |
| EPC9115 | Понижающий преобразователь 48 В/12 В | 48…60 | 12 | 42 | EPC2020/EPC2021 |
| EPC9118 | Понижающий преобразователь 48 В/5 В, 400 кГц | 30…60 | 5 | 20 | EPC2001/EPC2021 |
| EPC9506 | Демонстрационная плата беспроводного усилителя класса D | 8…32 | Uвх | 10 | EPC2014 |
| EPC9507 | Демонстрационная плата беспроводного усилителя класса D | 8…32 | Uвх | 6 | EPC2007 |
| EPC9508 | Демонстрационная плата беспроводного усилителя класса D | 7…36 | Uвх | 3 | EPC8009/EPC2007 |
Особо стоит отметить модули DrGaNPLUS. Они представляют собой миниатюрные платы, предназначенные для непосредственного встраивания в готовые устройства. Их габариты составляют всего 11×12 мм (рисунок 9). Рабочее напряжение составляет 30 В (EPC9201) или 80 В (EPC92013) (таблица 10).
Таблица 10. Характеристики готовых модулей DrGaNPLUS
| Наименование | Описание | Uси макс., В | Iс макс., А | Тип транзистора |
| EPC9201 | Полумостовая схема на дискретных транзисторах | 30 | 20 | EPC2015/EPC2023 |
| EPC9203 | Полумостовая схема на дискретных транзисторах | 80 | 40 | EPC2021 |
Заключение
Новые eGaN FET производства компании EPC отличаются низким сопротивлением «сток-исток», малой емкостью, высокой стабильностью параметров. В то же время работа с ними аналогична работе с традиционными MOSFET. При этом eGaN FET не только бросают вызов своим кремниевым собратьям, но и показывают превосходство в DC/DC-преобразователях, в усилителях мощности класса D, в инверторах, в системах беспроводной передачи мощности, в лидарах, в системах подстройки питания ВЧ-усилителей (Envelope Tracking), в системах с повышенной температурной и радиационной стойкостью.
За семь лет существования компания EPC смогла создать линейку продукции, состоящую из таких сегментов как:















